据晶飞半导体官微消息,近期,北京晶飞半导体科技有限公司在碳化硅晶圆加工技术领域取得重大突破,成功利用自主研发的激光剥离设备实现了12英寸碳化硅晶圆的剥离。
该突破标志着中国在第三代半导体关键制造装备领域迈出重要一步,为全球碳化硅产业的降本增效提供了全新解决方案。该技术此前在6/8英寸碳化硅领域已通过多家客户验证,设备性能达到国际先进水平。
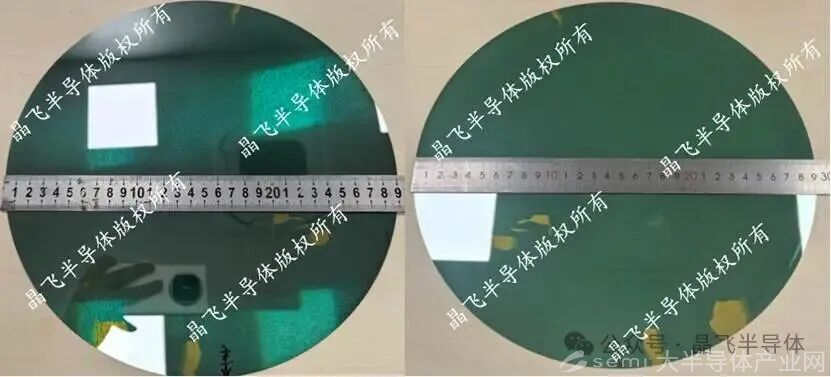
本次技术突破对碳化硅产业发展具有多重意义,主要包括:
1.大幅降低生产成本:12英寸碳化硅晶圆相比目前主流的6英寸晶圆,可用面积提升约4倍,单位芯片成本降低30%-40%
2.提升产业供给能力:解决了大尺寸碳化硅晶圆加工的技术瓶颈,为全球碳化硅产能扩张提供了设备保障
3.加速国产化替代进程:打破了国外厂商在大尺寸碳化硅加工设备领域的技术垄断,为我国半导体装备自主可控提供了重要支撑
4.促进下游应用普及:成本降低将加速碳化硅器件在新能源汽车、可再生能源等领域的应用