在SEMICON/FPD China 2026前夕,Kulicke & Soffa(库力索法,简称K&S)在上海举办媒体沟通会,围绕AI算力爆发、HBM高速迭代、先进封装与传统封装协同演进等行业焦点,全面阐述了在先进封装、存储封装、功率器件及点胶领域的最新技术进展与市场战略,展现了如何通过多技术平台协同,精准回应AI时代对封装工艺提出的更高要求。
中国市场传统封装业务强劲,AI与汽车双轮驱动
放眼全球,AI正在迎来爆发式增长,相关需求非常旺盛。“但这一增长并不均衡,主要集中在AI领域,其他IC领域的增长相对有限。而在中国大陆,情况则有所不同,AI和汽车电子都在快速发展,中国电动车产业在全球处于领先地位。”K&S全球销售与全球供应链高级副总裁黄文斌说道。
“K&S的传统封装业务在中国大陆的增长显著快于海外。我们的球焊机与楔焊机约80%销往中国,2026年这一比例有望继续上升。”黄文斌透露,目前K&S球焊机全球市场份额约70%,楔焊机市场份额达70%-80%,“K&S高度重视中国市场,这也是我们最大的市场。”
值得注意的是,中国大陆在传统封装领域的技术突破正加速推进。黄文斌提到,根据公开报道,HBM已在大陆实现封装,本土先进封装能力正快速提升。
先进封装:TCB领跑当前,Hybrid Bonding布局未来
K&S进入先进封装领域已有十年之久,目前聚焦于APU、CPU、AI Chip、GPU、Si Photonics及VCSEL等高增长领域,并已占据可观的市场份额。特别是在TCB技术上,经过多年持续投入,K&S已处于行业领先地位。他特别指出,K&S是目前业内唯一实现Fluxless TCB在客户端24小时量产的企业,这一技术突破为客户提供了更高的生产效率和更优的工艺可靠性。
在设备布局方面,K&S构建了清晰的产品路线图。其中,KATALYST设备专注于高精度倒装芯片封装,配备12个喷嘴,最高速度可达15000 uph,精度达3μm,主要应用于C4倒装芯片工艺。在TCB领域,公司推出了两代主力设备:第一代APAMA TCB面向中低端应用,精度达1.5μm,兼顾成本敏感型客户的需求;最新的第三代APTURA平台则瞄准AI、CPU、GPU等高端应用,精度提升至0.8μm,并支持最新的Fluxless TCB工艺。
针对当前业界主流的CoWoS封装方案,K&S的设备已广泛应用于多个关键环节。在Chip on Wafer方向,APTURA WWD设备将SoIC贴装至中阶层,并已在客户端实现24小时量产。在Chip on Substrate环节,APTURA WS同样是业内唯一采用Fluxless TCB进行24小时量产的设备,未来还将支持更大尺寸的基板。
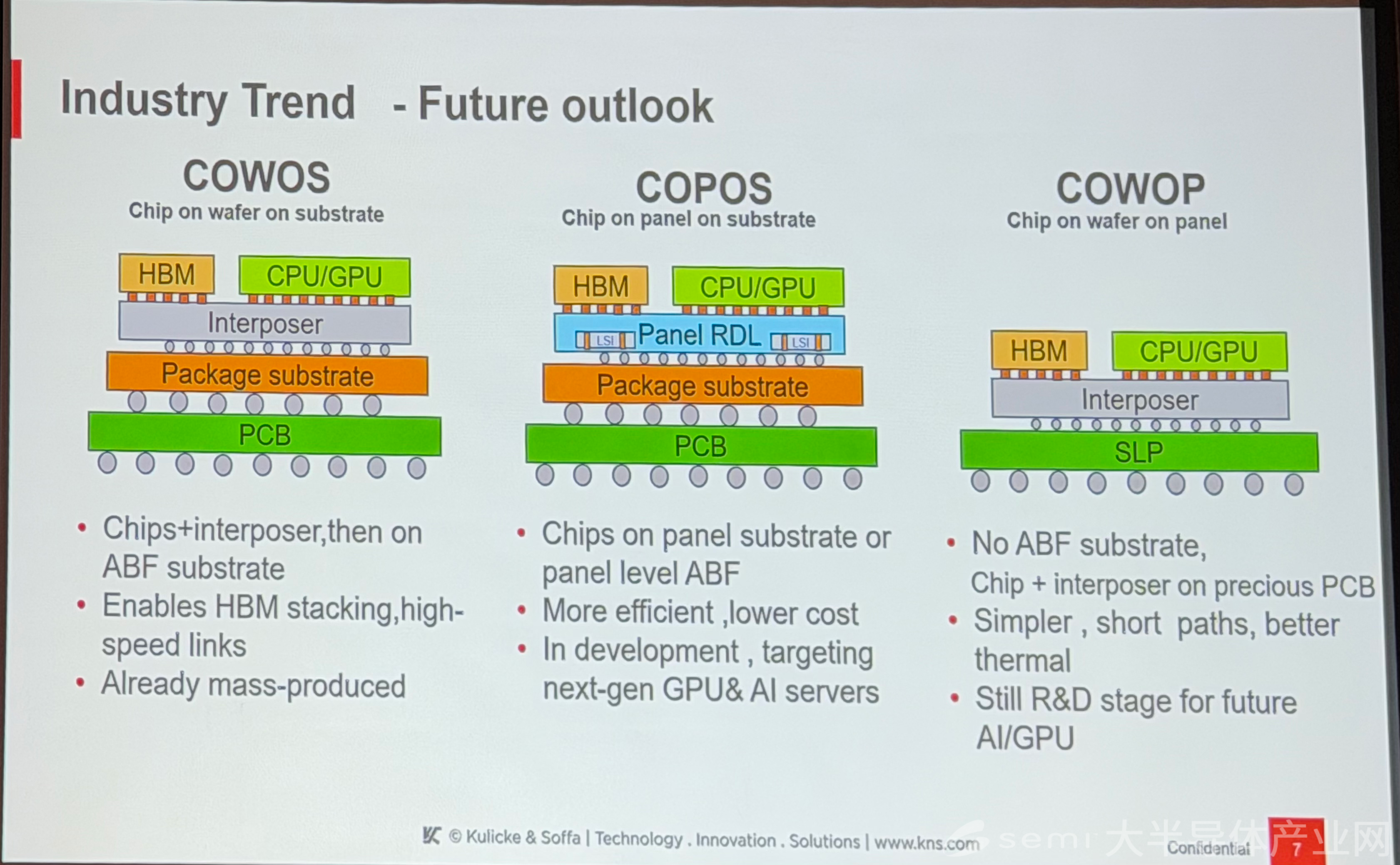
K&S先进封装事业部中国区产品经理赵华进一步指出,先进封装技术的两大新兴方向为CoPoS与CoWoP。CoPoS 的核心是用方形面板级RDL中介层替代传统的12寸晶圆,从而提高材料利用率、降低成本。CoWoP则进一步简化结构,通过将die直接贴装至高精度PCB,实现更短的线路和更强的散热能力。目前,CoPoS仍处于开发阶段,而CoWoP已从实验室进入验证阶段,预计很快将投入量产。
为适应这些新架构对更大尺寸封装的需求,K&S计划推出APTURA WP310及WSX等新机型,最大支持die size达150×150mm,基板尺寸扩展至310×310mm。此外,在混合键合(Hybrid Bonding)领域,K&S也已提前布局,预计将于明年上半年推出相关设备。
赵华指出,TCB与混合键合并非替代关系,而是互补共存。“以HBM为例,目前HBM 4将继续沿用TCB,当堆叠层数超过16层、厚度标准进一步收紧时,混合键合才会成为主流。这两种技术在未来相当长时期内将保持平衡。”
以智能化与全链路巩固传统封装优势
AI浪潮同样强烈拉动了存储市场需求。
K&S球焊机事业部资深产品经理范凯介绍,公司面向存储市场推出了ProMEM Suite工艺智能套件和ATPremier PLUS晶圆级键合设备。
ProMEM Suite是K&S第三代存储工艺智能产品,以AI驱动工艺智能套件,用户只需输入第一焊点的焊板尺寸、目标球径与球厚,或悬空结构中芯片厚度、悬空长度等基本参数,K&S即可通智能化的工艺模型帮助用户规划出最优路径。适配小间距、高密度、叠层结构,提升良率与效率。
ATPremier PLUS则是目前市场上唯一适用于12寸晶圆焊接互连的可行技术方案,支持8/12寸晶圆,可对接工厂自动化。在工艺层面,既可以实现晶圆上植球倒装焊,也可以支持垂直焊线,以及叠层芯片晶圆级或面板级互连方案。设备还集成线焊监控类功能,可检测焊接性能和垂直线高度等。
功率器件市场同样是K&S重点布局领域。
面向新能源汽车、功率模块,K&S推出Terminal Welder端子焊接机,实现从“点”到“面”的焊接突破。K&S楔焊机事业部资深产品经理陈兰兰介绍,与传统锡膏工艺相比,端子焊无需助焊剂,无挥发污染,无需外部加热,兼具绿色环保与成本优势。同时,其焊点支持theta角旋转,深腔作业垂直行程达150mm,为模块设计提供了更大灵活性。
在点胶业务上,K&S先进流体定量涂布事业部技术解决方案资深经理戴子褀介绍了ACELON点胶平台及应用矩阵。该平台湿胶精度控制在20μm以内,KOZ(禁涂区域)可小于180μm,能够满足AI芯片等高精度封装需求。设备采用模块化设计,并集成了基于机器学习的工艺优化算法,可实现点胶参数的自动化调整与闭环控制。
影像系统是不容忽视的优势之一,据介绍,ACELON平台内置了Post Inspection功能,可在点胶完成后对位置、宽度、高度进行检测,并支持MAV(Machine Accuracy Verification)功能,可通过预设的自动化流程自动生成CpK报告并上传MES系统,这一功能尤其受到汽车客户的青睐。
写在最后
AI浪潮与HBM技术推动封装市场快速发展。范凯则将K&S的战略概括为“先进封装是未来,传统封装是生活,两条腿走路”。从资源配置来看,尽管先进封装在研发投入上占比更高,但从营收结构看,传统封装仍占60%左右,若按设备台数计算则超过70%。
这种平衡布局使K&S既能把握AI驱动的先进封装增量机遇,又能持续巩固其在传统封装领域的领先地位。