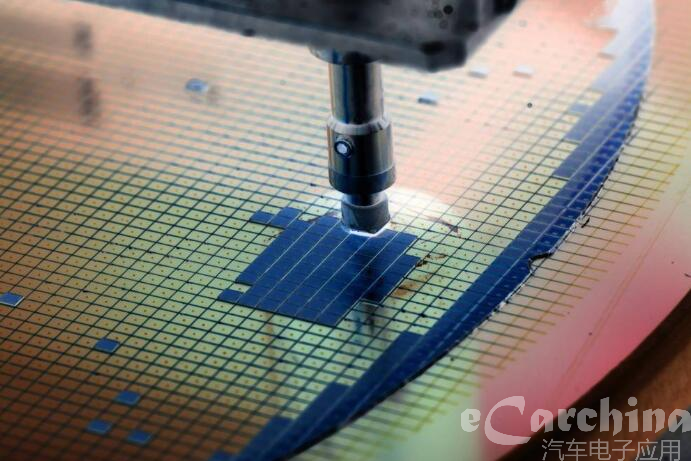
12月12日消息,根据科创板日报消息,半导体切割设备制造商迪思科(DISCO)开发出了车用节能半导体的新型切割机,速度是过去的10倍。据悉,碳化硅(SiC)作为半导体材料的功率效率很高,但材质偏硬很难加工,新设备的研发将确立新一代功率半导体的量产技术,有望推动纯电动汽车的普及。
目前,迪思科已开始面向部分客户供货,将在订单增加之后正式量产。
DISCO是全球领先的半导体制造设备厂商,专注于晶圆减薄、抛光和切割领域。DISCO创造性地采用KABRA技术、4轴磨削和干法抛光、超声波切割和隐形切割,分别在碳化硅片制造、器件减薄、切割环节实现了显著的优化效果。与硅相比,碳化硅的磨削和切割更为复杂,DISCO占据了功率半导体市场的绝对份额。


.jpg)

