近日,苏州晶湛半导体有限公司发布了新型多沟道AlGaN/GaN异质结构外延片产品,在保持高电子迁移率的同时,将载流子浓度提高了4倍以上。基于苏州晶湛提供的该新型外延材料,瑞士洛桑联邦理工学院(EPFL)在多沟道高电子迁移率晶体管技术上实现了突破,同时实现了>1200V的高击穿电压以及低导通电阻,极大地提高了功率转化效率。
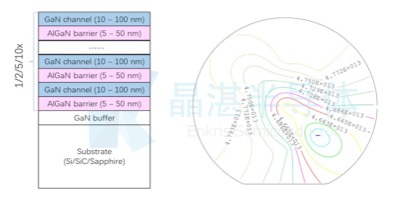
图:多沟道GaN HEMT结构外延片及其典型2DEG分布
近年来,随着GaN电力电子器件的广泛应用,大大促进了如大功率快速充电器,太阳能光伏以及新能源汽车等领域的技术创新和快速发展。为了进一步满足大功率系统中的超高转化效率的要求,需要同时实现高击穿电压以及低导通电阻。而在高电压应用下,氮化镓器件的发热/能量的损耗主要由导通电阻引起,这是电力电子器件的最大挑战。
针对这一非常具有挑战性的课题,从2017年起,苏州晶湛半导体有限公司与瑞士洛桑联邦理工学院(EPFL)合作共同研发多沟道高电子迁移率晶体管技术。这项技术采用苏州晶湛半导体独特的多沟道异质结构外延片 (multi-channel AlGaN/GaN heterostructure),通过若干个垂直集成的二维电子气(2DEG)通道,在保持高电子迁移率的同时增加沟道中的载流子密度,其效果如同增加多个新的快速车道,分流高速运动的载流子,从而有效地降低了导通电阻和发热。在此新型多沟道外延片材料基础上制备的MOSHEMT器件,采用类似鳍式场效应晶体管(FinFET)的结构,独特的漏斗状栅极设计可以有效地控制多个通道且固有电容较小。基于上述技术开发的耗尽型以及增强型新型纳米线功率晶体管,实现了低至2.5Ω mm以及3.2Ω mm导通电阻,同时保持1300V 的击穿电压,功率品质因数高达4.6 GW cm−2(耗尽型)以及3.8 GW cm−2 (增强型)。相关研究结果发表于行业顶级期刊Nature Electronics,IEEE Electron Device Letters,以及国际顶级会议IEDM,引起了广泛的关注。
苏州晶湛半导体有限公司创始人兼CEO,程凯博士评论道:“我们在研发的一开始采用了大尺寸Si衬底生长基于氮化镓材料的多沟道异质结构,并且尝试了多种结构设计。目前优化的设计可以在厚度为130nm的4层沟道AlGaN/GaN异质结中,实现<100 Ωsq-1的面电阻,>4x1013cm-2的载流子浓度(Ns)以及>1,800 cm2V-1S-1的迁移率(µ)。多沟道设计可以突破单沟道器件的理论极限,进一步减少开态电阻和系统损耗,并能达到1200V系统的要求,大大提高GaN器件在高压功率领域的竞争优势,在电动汽车、充电桩等高压应用领域具有很大的潜力。此外,我们已具备在Si、SiC、蓝宝石等多种不同衬底上外延类似多沟道异质结构的能力,这种新型多沟道异质结构器件在电力电子、通信射频等领域有非常广阔的应用空间。“



.jpg)

